Como aplicar MOSFETs de SiC de terceira geração a projetos de potência para maior desempenho e eficiência
Contributed By DigiKey's North American Editors
2022-11-02
Existe um acionamento incansável para maior eficiência, tamanho menor e melhor desempenho em aplicações de potência, tais como acionadores de motores industriais, inversores/conversores CA/CC e CC/CC, carregadores de bateria e sistemas de armazenamento de energia. Estas exigências de desempenho agressivo ultrapassaram as capacidades dos MOSFETs de silício (Si) e deram origem a novas arquiteturas de transistor baseadas em carbeto de silício (SiC).
Embora estes dispositivos mais novos oferecessem benefícios significativos através das principais métricas de desempenho, os projetistas foram prudentes em desconfiar dos dispositivos SiC de primeira geração devido a várias limitações e incertezas de aplicação. Os dispositivos de segunda geração trouxeram especificações melhoradas com uma melhor compreensão das sutilezas dos dispositivos. À medida que o desempenho do MOSFET de SiC aumentava e o tempo de colocação no mercado se intensificava, os projetistas utilizavam estes novos dispositivos para atender aos objetivos do produto. Mais recentemente, os dispositivos de terceira geração estão demonstrando a maturidade dos dispositivos de potência baseados em SiC. Estes dispositivos proporcionam aos usuários melhorias através de parâmetros-chave, ao mesmo tempo em que se baseiam na experiência de design e na experiência relacionada das gerações anteriores.
Este artigo compara Si com SiC, antes de discutir o desenvolvimento e migração para MOSFETs de SiC de terceira geração. Em seguida, apresenta exemplos do mundo real da Toshiba Semiconductor and Storage Corp. (Toshiba) para mostrar como estes dispositivos podem ajudar os projetistas a alcançar avanços significativos no projeto de sistemas de potência.
Silício versus SiC
Nas últimas décadas, o MOSFET à base de silício transformou o projeto de sistemas de potência que vão desde fontes básicas e inversores até acionamentos de motores. Junto com o transistor bipolar de porta isolada (IGBT) — um semicondutor funcionalmente semelhante, mas com construção e atributos muito diferentes -— o MOSFET de Si com chaveamento otimizado permitiu uma transição da conversão e gerenciamento de energia tradicional, ineficiente e baseado em topologias lineares, para uma abordagem muito mais eficiente e compacta usando o controle chaveado.
A maioria destes projetos usa uma forma de modulação por largura de pulso (PWM) para fornecer e manter a tensão, corrente ou valor de potência desejado em um arranjo de realimentação de malha fechada. À medida que o uso de MOSFETs de silício crescia, as exigências impostas a eles também aumentavam. Além disso, novas metas de eficiência (muitas baseadas em mandatos regulatórios), os mercados para veículos elétricos e controle mais inteligente de motores, conversão de energia para energia renovável e sistemas de armazenamento de energia associados, impulsionaram estes MOSFETs a fazer mais e melhor.
Como resultado, um esforço considerável de P&D melhorou o desempenho dos MOSFETs baseados em silício, mas os pesquisadores perceberam que este esforço estava chegando ao ponto de diminuir os retornos. Felizmente, eles tinham uma alternativa, em teoria, baseada em dispositivos de chaveamento de potência que utilizavam SiC como substrato em vez de apenas silício.
Por que usar o SiC?
Por várias razões físicas profundas, o SiC tem três características elétricas principais que diferem significativamente do silício sozinho, e cada uma traz vantagens operacionais; há também outras diferenças mais sutis (Figura 1).
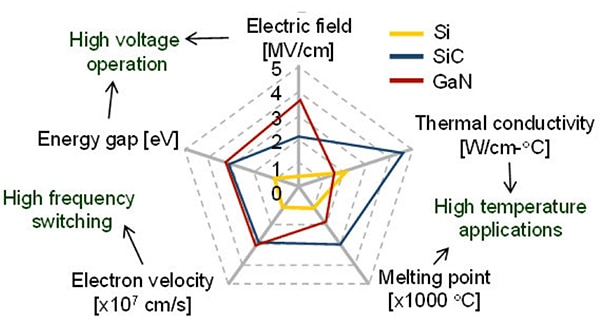 Figura 1: Comparação aproximada entre as principais propriedades dos materiais sólidos de SiC versus Si e nitreto de gálio (GaN). (Fonte da imagem: Researchgate)
Figura 1: Comparação aproximada entre as principais propriedades dos materiais sólidos de SiC versus Si e nitreto de gálio (GaN). (Fonte da imagem: Researchgate)
As três principais características são:
- Tensão de campo elétrico de ruptura crítica mais alta de cerca de 2,8 megavolts/centímetro (MV/cm) versus 0,3 MV/cm, de modo que a operação a uma determinada tensão nominal é possível com uma camada muito mais fina, reduzindo muito a resistência de saturação de dreno-fonte (RDS(on)).
- Maior condutividade térmica, permitindo uma maior densidade de corrente em uma área de seção transversal.
- Banda proibida mais larga (a diferença de energia em elétron-volt entre o topo da banda de valência e o fundo da banda de condução em semicondutores e isoladores), resultando em menor corrente de fuga em altas temperaturas. Por esta razão, os diodos de SiC e transistores de efeito de campo (FETs) são frequentemente mencionados como dispositivos de banda proibida (WBG).
Como resultado, os dispositivos baseados em SiC podem bloquear tensões até dez vezes maiores que as estruturas somente de silício, podem comutar cerca de dez vezes mais rápido, e têm um RDS(on) pela metade ou menos a 25°C, enquanto utilizam a mesma área de matriz (todos os valores aproximados, é claro). Além disso, a perda relacionada ao chaveamento no corte dos dispositivos de SiC é menor porque não há corrente de cauda prejudicial. Ao mesmo tempo, sua capacidade de operar a temperaturas muito mais altas de cerca de 200°C, contra 125°C, facilita o projeto térmico e as questões de gerenciamento.
Devido a seus atributos de desempenho e avanços, os dispositivos de SiC agora ocupam um lugar de destaque na matriz de aplicação de potência vs. velocidade, unindo IGBTs, MOSFETs de silício e dispositivos de GaN (Figura 2).
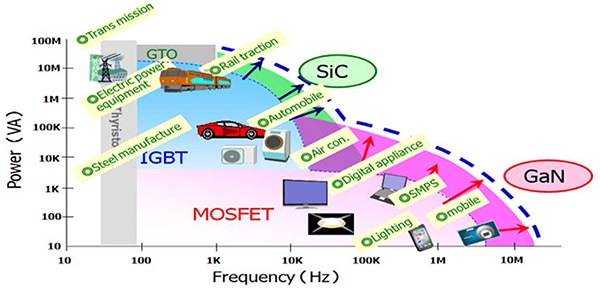 Figura 2: Os atributos de desempenho dos MOSFETs de SiC os tornam adequados para uma ampla gama de aplicações, abrangendo uma faixa de potências e frequências. (Fonte da imagem: Toshiba)
Figura 2: Os atributos de desempenho dos MOSFETs de SiC os tornam adequados para uma ampla gama de aplicações, abrangendo uma faixa de potências e frequências. (Fonte da imagem: Toshiba)
O caminho da ciência dos materiais de SiC subjacentes e da física dos dispositivos até os MOSFETs de SiC comerciais não foi rápido nem fácil (Figura 3). Após extensos esforços de pesquisa e produção, os primeiros dispositivos baseados em SiC — os diodos Schottky — foram introduzidos em 2001. Nas duas décadas seguintes, a indústria desenvolveu e liberou volumes de produção de MOSFETs de SiC de primeira, segunda e terceira geração. Cada geração oferece melhorias direcionadas em parâmetros específicos, com contrapartidas um pouco diferentes.
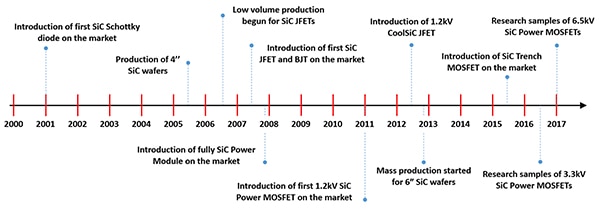 Figura 3: A história dos dispositivos comerciais baseados em SiC começa com os primeiros diodos Schottky comerciais de SiC , que apareceram em 2001. (Fonte da imagem: IEEE Transactions on Industrial Electronics, 2017)
Figura 3: A história dos dispositivos comerciais baseados em SiC começa com os primeiros diodos Schottky comerciais de SiC , que apareceram em 2001. (Fonte da imagem: IEEE Transactions on Industrial Electronics, 2017)
Note que é importante ser claro sobre a terminologia: assim como seus predecessores somente de silício, os FETs baseados em SiC são MOSFETs. No sentido amplo, suas estruturas físicas internas são similares, e ambos são dispositivos de três terminais com conexões de fonte, dreno e porta. A diferença é como seus nomes indicam: Os FETS baseados em SiC utilizam SiC como material de base em vez de apenas silício.
Comece com a primeira e a segunda geração
Há muitos parâmetros que caracterizam o desempenho de um dispositivo de chaveamento. Entre os muitos parâmetros estáticos estão a máxima tensão operacional e a máxima corrente nominal, junto com duas Figuras de Mérito estáticas (FoMs): o RDS(on) e a máxima temperatura operacional, que estão relacionadas com a capacidade de lidar com a potência para um determinado tamanho de matriz e invólucro.
Como os dispositivos de chaveamento, os parâmetros dinâmicos também são críticos, pois são necessários para avaliar as perdas de chaveamento. O FoM dinâmico mais citado é o produto do RDS(on) e da carga na porta, RDS(on) × Qg, enquanto um cada vez mais importante é a carga de recuperação reversa, Qrr. O dimensionamento e as capacidades do acionador de porta necessários para fornecer corretamente a corrente de fonte e dreno ao dispositivo de chaveamento — e fazê-lo sem excesso, vibração ou outra distorção — é determinado principalmente por estes FoMs.
O uso e o crescimento do mercado de dispositivos de SiC de primeira geração tinham sido retardados por questões de confiabilidade. Um deles envolve os diodos PN, que são posicionados entre a fonte e dreno de alimentação do MOSFET. A tensão aplicada ao diodo PN o energiza, resultando em uma mudança da resistência de saturação que degrada a confiabilidade do dispositivo.
A segunda geração da Toshiba modificou a estrutura básica do dispositivo de SiC, usando um diodo de barreira Schottky (SBD) incorporado no MOSFET para resolver em grande parte este problema (Figura 4). Isto melhorou a confiabilidade em mais do que uma ordem de grandeza. A nova estrutura impediu a energização do diodo PN ao posicionar o diodo SBD em paralelo com o diodo PN dentro da célula. A corrente flui através do SBD incorporado porque sua tensão no estado de condução é menor do que a do diodo PN, suprimindo assim algumas mudanças na resistência de saturação e degradação da confiabilidade do MOSFET.
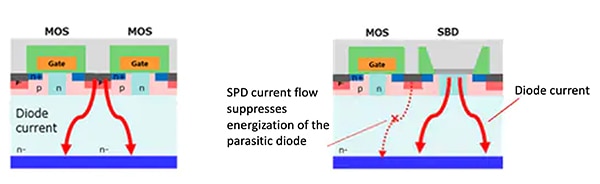 Figura 4: Ao contrário do típico MOSFET de SiC sem um diodo de barreira Schottky (SBD) interno (esquerda), o outro com ele (direita) pode minimizar a energização do diodo PN parasita. (Fonte da imagem: Toshiba)
Figura 4: Ao contrário do típico MOSFET de SiC sem um diodo de barreira Schottky (SBD) interno (esquerda), o outro com ele (direita) pode minimizar a energização do diodo PN parasita. (Fonte da imagem: Toshiba)
Os MOSFETs com SBDs incorporados já estavam em uso prático, mas somente em produtos de alta tensão — como os dispositivos de 3,3 quilovolts (kV) — já que o SBD incorporado fez com que a resistência de saturação aumentasse a um nível que somente os produtos de alta tensão podem tolerar. A Toshiba ajustou vários parâmetros do dispositivo e descobriu que a relação da área do SBD em um MOSFET é o segredo para suprimir o aumento da resistência de saturação. Ao otimizar a relação do SBD, a Toshiba concebeu um MOSFET de SiC de categoria 1,2 kV com notável melhoria na confiabilidade.
No entanto, como em muitas outras melhorias, houve contrapartidas. Embora a nova estrutura do dispositivo tenha melhorado significativamente a confiabilidade, ela também teve um efeito prejudicial em dois FoMs. Aumentou o RDS(on) nominal assim como o RDS(on) × Qg, reduzindo o desempenho do MOSFET. Para compensar e reduzir a resistência de saturação, os MOSFETs de SiC de segunda geração tinham aumentado a área da matriz, mas isto aumentou o custo.
A terceira geração mostra verdadeira maturidade
Reconhecendo esta preocupação, a Toshiba desenvolveu uma terceira geração de dispositivos de MOSFET de SiC, chamada família TWXXXN65C/TWXXXN120C. Estes dispositivos otimizaram a estrutura da camada a fim de espalhar a corrente para reduzir o tamanho da célula e também proporcionar uma maior tensão nominal, chaveamento mais rápido e menor resistência de saturação.
A resistência de saturação é reduzida em parte pela redução da resistência de espalhamento (Rspread). A corrente do SBD é aumentada pela injeção de nitrogênio no fundo da ampla região de difusão tipo P (Poço P) do MOSFET de SiC. A Toshiba também reduziu a região JFET e injetou nitrogênio para reduzir a capacitância de realimentação e a resistência JFET. Como resultado, a capacitância de realimentação foi reduzida sem aumentar a resistência de saturação. A operação estável sem flutuação da resistência de saturação também foi obtida pelo posicionamento otimizado do SBD.
Atualmente, a família é composta de MOSFETs de SiC de 650 volts e 1.200 volts projetados para aplicações industriais de alta potência, tais como fontes de alimentação CA/CC de 400 volts e 800 volts, inversores fotovoltaicos (PV) e conversores bidirecionais CC/CC para fontes de alimentação ininterrupta (UPSs). Tanto os MOSFETs de SiC de 650 e 1.200 volts são oferecidos no invólucro padrão da indústria de três condutores TO-247 (Figura 5).
 Figura 5: Alojados em um invólucro padrão T0-247, os MOSFET de SiC de 650 volts e 1200 volts de terceira geração da Toshiba são bem adequados para uma ampla gama de aplicações de conversão de energia, controle e gerenciamento. (Fonte da imagem: Toshiba)
Figura 5: Alojados em um invólucro padrão T0-247, os MOSFET de SiC de 650 volts e 1200 volts de terceira geração da Toshiba são bem adequados para uma ampla gama de aplicações de conversão de energia, controle e gerenciamento. (Fonte da imagem: Toshiba)
Nestes MOSFETs de SiC de terceira geração, o FoM RDS(on) × Qg é reduzido em 80% em comparação com os dispositivos de segunda geração da Toshiba —- uma queda significativa — enquanto que a perda de chaveamento é reduzida em cerca de 20%. A tecnologia de diodo de barreira Schottky incorporado também oferece uma tensão direta (VF) ultra baixa.
Existem outras sutilezas de design associadas aos MOSFETs. Tomemos o VGSS, por exemplo. VGSS é a tensão máxima que pode ser aplicada entre a porta e a fonte quando o dreno e a fonte estão em curto-circuito. Para dispositivos de SiC de terceira geração, a faixa de VGSS é de 10 a 25 volts, sendo 18 volts o valor recomendado. Os amplos dimensionamentos de VGSS ajudam a facilitar o projeto, ao mesmo tempo em que melhoram a confiabilidade.
Além disso, a baixa resistência e uma maior tensão de limiar de (VGS(th)) — a tensão na qual o canal MOSFET começa a conduzir — ajuda a prevenir mau funcionamento, tais como a ativação acidental devido a picos, falhas e excessos. Esta tensão varia de 3,0 a 5,0 volts, ajudando a garantir um desempenho de chaveamento previsível com um desvio mínimo, ao mesmo tempo em que permite um projeto simples do acionador de porta.
Um olhar mais atento aos MOSFETs de SiC de 650 volts e 1200 volts de terceira geração
Um olhar sobre dois dispositivos em extremos opostos do espectro da família, os dispositivos de 650 volts e 1200 volts mostra o alcance de suas capacidades. O invólucro físico, pinagem e o símbolo esquemático para todos eles é o mesmo (Figura 6), mas as especificações diferem.
 Figura 6: Todos os membros da família MOSFET de SiC de terceira geração da Toshiba têm o mesmo arranjo físico e símbolo esquemático; observe o diodo de barreira Schottky integrado no símbolo. (Fonte da imagem: Toshiba)
Figura 6: Todos os membros da família MOSFET de SiC de terceira geração da Toshiba têm o mesmo arranjo físico e símbolo esquemático; observe o diodo de barreira Schottky integrado no símbolo. (Fonte da imagem: Toshiba)
Um dispositivo de 650 volts é o TW015N65C, um dispositivo de canal N dimensionado para 100 amperes (A) e 342 watts. Seus valores típicos de especificação são uma capacitância de entrada (CISS) de 4.850 picofarads (pF), uma baixa carga na porta de entrada (Qg) de 128 nanocoulombs (nC), e um RDS(on) nominal de apenas 15 miliohms (mΩ).
Junto com tabelas de valores mínimos, típicos e máximos para parâmetros estáticos e dinâmicos, a ficha técnica tem gráficos que mostram o desempenho de parâmetros críticos versus fatores como temperatura, corrente de dreno e tensão de porta-fonte (VGS). Por exemplo, o valor de RDS(on) versus temperatura, corrente de dreno (ID), e tensão de porta-fonte VGS é mostrado na Figura 7.
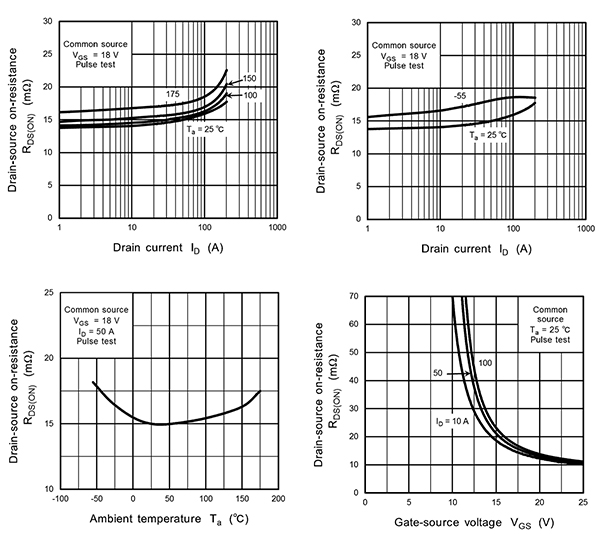 Figura 7: São mostrados os gráficos que caracterizam a resistência de saturação do TWO15N65C a partir de diferentes perspectivas, incluindo corrente de dreno, temperatura ambiente e VGS. (Fonte da imagem: Toshiba)
Figura 7: São mostrados os gráficos que caracterizam a resistência de saturação do TWO15N65C a partir de diferentes perspectivas, incluindo corrente de dreno, temperatura ambiente e VGS. (Fonte da imagem: Toshiba)
O mesmo conjunto de especificações e gráficos são mostrados na Figura 8 para os dispositivos de 1200 volts, como o TW140N120C, um dispositivo de canal N, 20 A e 107 watts. Este MOSFET de SiC apresenta um CISS baixo de 6000 pF, uma carga na porta de entrada (Qg) de 158 nanocoulombs (nC), e um RDS(on) de 140 mΩ.
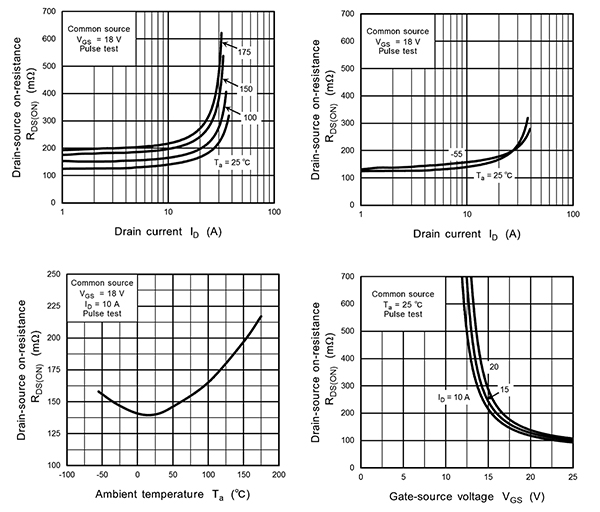 Figura 8: Gráficos de caracterização da resistência de saturação do TW140N120C. (Fonte da imagem: Toshiba)
Figura 8: Gráficos de caracterização da resistência de saturação do TW140N120C. (Fonte da imagem: Toshiba)
Os dez MOSFETs de SiC de terceira geração da Toshiba disponíveis compreendem cinco dispositivos de 650 volts com cinco dispositivos de 1200 volts. A 25°C, eles têm os seguintes dimensionamentos de resistência de saturação, corrente e potência:
650 volts:
- 15 mΩ, 100 A, 342 watts (o TWO15N65C)
- 27 mΩ, 58 A, 156 watts
- 48 mΩ, 40 A, 132 watts
- 83 mΩ, 30 A, 111 watts
- 107 mΩ, 20 A, 70 watts
1200 volts:
- 15 mΩ, 100 A, 431 watts
- 30 mΩ, 60 A, 249 watts
- 45 mΩ, 40 A, 182 watts
- 60 mΩ, 36 A, 170 watts
- 140 mΩ, 20 A, 107 watts (o TW140N120C)
Conclusão
Os MOSFETs de carbeto de silício oferecem uma melhoria significativa nos parâmetros críticos de chaveamento, em relação aos dispositivos somente de silício. Em comparação com as gerações anteriores, os componentes de SiC de terceira geração oferecem especificações e FoMs melhorados, maior confiabilidade, melhor caracterização das exigências do acionador de porta, e maior percepção dentro das sutilezas do design inevitável. Usando estes MOSFETs de SiC, os projetistas de sistemas de potência têm um recurso central adicional que podem usar para alcançar maior eficiência, tamanho menor e melhor desempenho geral.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.





